カルコパイライト系材料を適用した低電圧増倍型光電変換膜の開発
テレビカメラの感度を抜本的に改善するために,光電変換した信号電荷をCMOS(Complementary Metal Oxide Semiconductor)回路の耐電圧以下で増倍可能な,低電圧増倍型光電変換膜の研究開発を進めている。今回,可視光全域で高い感度を有するカルコパイライト系材料CIGS(CuIn1-xGax(Se1-ySy)2)に,暗電流を低減するための正孔注入阻止層として酸化ガリウム(Ga2O3)を適用したGa2O3/CIGS構造を試作し,光電特性を評価した。Ga2O3/CIGS構造の量子効率は可視光平均で95%(印加電圧4V)となった。また,印加電圧5V以下の低電圧で,信号電流の増倍現象を確認した。
1.はじめに
当所では,多画素化や高フレームレート化が進むテレビカメラの感度不足の問題を抜本的に解決するために,信号電荷の増倍が可能な光電変換膜をCMOS(Complementary Metal Oxide Semiconductor)回路上に積層した新たな高感度イメージセンサーの研究・開発を進めている。
電荷増倍の原理としては,当所が以前に開発したHARP(High-gain Avalanche Rushing amorphous Photoconductor)1)*1 と同様なアバランシェ(なだれ)増倍*2 を想定しているが,CMOS回路の耐電圧(一般に数V ~数十V)以下の低い電圧で,アバランシェ増倍の元となるインパクトイオン化に必要な電界(107V/m)2) を得るには,可視光に対して高い光吸収係数*3 を有する光電変換材料を用い,光電変換膜を薄くする必要がある。
今回,その候補の1つであるカルコパイライト系材料*4 CIGS(CuIn1-xGax(Se1-ySy)2)に,正孔注入阻止層*5 として酸化ガリウム(Ga2O3)を適用したGa2O3/CIGS構造の光電変換膜を試作し,5V以下の低い印加電圧で,信号電荷の増倍現象が起こることを確認した。
本稿では,CIGSの概要および光電変換膜構造の設計指針について述べた後,試作した光電変換膜の光電特性について報告する。
2.CIGSの概要
CIGSは銅(Cu),インジウム(In),ガリウム(Ga),セレン(Se)または硫黄(S)で構成される化合物半導体であり,光吸収係数および量子効率*6 が高く,構成元素比の調整によりバンドギャップ*7 が制御可能であることから,主に太陽電池の光電変換材料として研究・実用化されている3)。1図に,2種類のCIGS(CuInSe2,CuGaSe2)を含む各種半導体の光吸収係数を示す4)。この図から分かるように,CIGSは各種半導体の中でも特に高い光吸収係数(可視光に対して約105cm-1)を有しており,500~1,000nmの膜厚があれば,可視光を十分に吸収することができる。また,この程度の膜厚であれば,5~10Vの印加電圧で,膜内にインパクトイオン化に必要な107V/mの電界を発生させることが可能であることから,CMOS回路上で電荷増倍を実現する可能性を持った材料と言える。

3.CIGSを用いた光電変換膜構造の設計指針
CIGSを用いた太陽電池においては,p型半導体*8 であるCIGSに対し,n型半導体*9 である硫化カドミウム(CdS)を組み合わせるケースが一般的である。これは,CdS成膜時にカドミウム(Cd)がCIGS表面に拡散してn型CIGSが形成されることで良好なpn接合が得られるなどの理由からである5)。一方,CdSのバンドギャップは2.4eVと比較的小さく,青色光(波長520nm以下)を吸収するため,光電変換層であるCIGSに青色光が届かない。このため,可視光用イメージセンサーの光電変換材料としてCIGSを用いる場合には,それと組み合わせるn型半導体としてCdS以外の材料を適用する必要がある。
新たなn型半導体材料を探索するにあたっては,低い暗電流での電荷増倍が可能であったHARPの研究成果から得られた知見を基に6),以下の4条件を指針とした。
ここで①は,可視光全域で高い感度を得るためには必須の条件であり,②は,暗電流*12 の主な要因の1つである,電極からの注入電荷(この場合は正孔)を阻止するために必要である。③は,電子障壁が大きいと,光から生成された電子がその障壁に捕獲されて,撮像時に残像や焼付といった問題を生じることによる。④は,欠陥準位が多数存在すると,実効的な正孔障壁が低下するためである6)。
これらの条件を指針として検討を重ねた結果,CIGSに適用するn型半導体としてGa2O3を採用した。Ga2O3はバンドギャップが4.7eVと大きく,実際にスパッター法*13 で成膜したGa2O3(膜厚100nm)の透過率を測定した結果,可視光域(波長400 ~ 700nm)での平均値は98%となり,①を満足する。2図にGa2O3/CIGS構造のエネルギーバンド図を示す。光入射側の透明電極としてITO(Indium Tin Oxide:酸化インジウムスズ)を使用した場合,電極から見た正孔障壁は3.5eVとなる。これは正孔注入阻止性能が高く暗電流が少ないHARPの正孔障壁(2.8eV)6)より高く,②を満たす。また,電子障壁は0.6eVとなり,③も満たすことが分かる。④については,後述するように,Ga2O3内の欠陥準位を低減する成膜条件を見いだした。
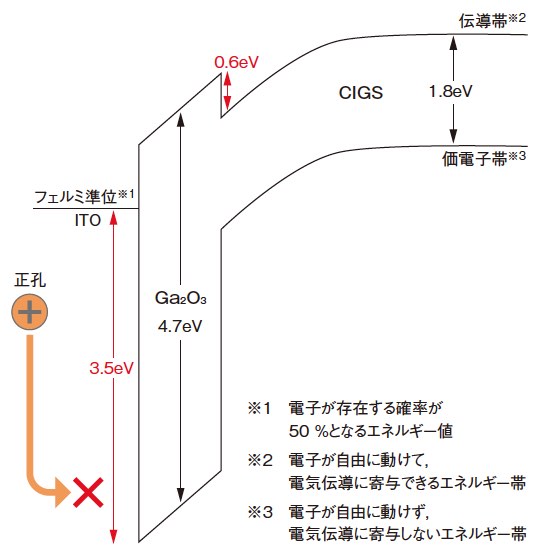
4.Ga2O3/CIGS構造の試作
Ga2O3/CIGS構造の光電特性を評価するために,3図に示すサンプルを試作した。
始めに,ガラス基板上に裏面金属電極として膜厚1µmのモリブデン(Mo)をスパッター法で成膜した。
次に,CIGS(膜厚1µm)を多元蒸着法で成膜した。多元蒸着法は,Cu,In,Ga,Seの各材料をそれぞれルツボに充填して各々を加熱し,各材料を蒸発させることで基板上に成膜させる方法である。各ルツボの温度を制御することで,Cu,In,Ga,Seの蒸発量を変化させ,所望の組成比を得ることができる。
4図にCIGS薄膜の成膜プロセスを示す。これはNREL(National Renewable Energy Laboratory:米国立再生可能エネルギー研究所)が開発した多元蒸着法の一種であり,三段階法と呼ばれる成膜プロセスである7)。高品質な膜が得られ,再現性も高いため,高効率CIGS太陽電池の成膜法として一般的に用いられている。
4図の成膜プロセス(①~④)の詳細は,以下の通りである。
- 最初に基板温度300 ~ 350℃で,In,Ga,Se(ルツボ温度:In 880℃,Ga 1,000℃,Se 210℃)を蒸発させる(成膜時間10~15分)。このとき,裏面電極であるMoとSeとの間で反応が起こり,薄い二セレン化モリブデン(MoSe2)層が形成される。このMoSe2層の働きによってMoとCIGSとの間で良好なオーミック特性*14 が得られるようになる(MoとSeの間に整流特性 *15 が生じると感度低下などの問題が生じる)。
- 次に基板温度を450~500℃に昇温させながら,Cu,Se(ルツボ温度:Cu 1,150℃,Se 210℃)を蒸発させる(成膜時間5~10分)。
- 続いて基板温度はそのままで,再度In,Ga,Se(ルツボ温度:In 860℃,Ga 975℃,Se 210℃)を蒸発させる(成膜時間1~2分)。
- 最後にSeの再蒸発に伴うCIGSのSe欠損を防ぐ目的で,基板温度を下げながらSe(ルツボ温度Se170℃)を蒸発させる(成膜時間20~40分)。
3図のGa2O3(膜厚100nm)はスパッター法で成膜した。この際,欠陥準位の原因となるGa2O3膜内の酸素欠陥*16 を低減するために,Ga2O3成膜中の酸素(O2)分圧を0~1.0×10-1Paの間で変化させて最適条件を検討した(5章を参照)。
最後に,表面透明電極としてITO(膜厚30nm)をスパッター法で成膜した。


5.試作したGa2O3/CIGS構造の光電特性
5図にGa2O3/CIGS構造の暗電流-電圧特性を示す。ITO電極を陰極,Mo裏面電極を陽極としたときが順バイアス,ITO電極を陽極,Mo裏面電極を陰極としたときが逆バイアスである。順バイアス状態で電流が大きく流れ,逆バイアス状態で電流がほとんど流れない明確な整流特性が得られたことから,Ga2O3とCIGSとの間で良好なpn接合が形成されたことが確認できた(可視光用イメージセンサーとしては,暗電流の低い逆バイアス状態を利用する)。なお5図では,Ga2O3成膜中の酸素(O2)分圧は6.0×10-2Paとした。
6図にGa2O3成膜中のO2分圧を変えたときの暗電流-電圧特性を示す。暗電流特性はGa2O3成膜中のO2分圧に大きな影響を受けることが分かる。Ga2O3成膜中にO2を導入しない場合,暗電流は1V印加時で10-3A/cm2台と最も高い値となった。暗電流が大きくなる原因としては,Ga2O3内に酸素欠陥が多数発生し,Ga2O3が形成する実効的な正孔障壁が低下したためと考えられる。すなわち,Ga2O3内に酸素欠陥が多数発生すると,Ga2O3が形成する正孔障壁内に欠陥準位(多数の穴)が生じる。ITO電極側から注入される正孔は信号電荷(光電変換膜に入射した光子が変換されて発生する正孔)とは無関係であり,暗電流の要因となる。本来は,正孔障壁によって電極からの正孔注入は阻止される。しかし,正孔障壁内に欠陥準位(多数の穴)が存在すると,注入された正孔はその穴を通してCIGS側へ入ってしまうため,実効的な正孔障壁を低下させる原因となる。本実験においては,O2分圧を3.0×10-2Pa,6.0×10-2Paと高めていくと,暗電流は顕著に低減した。これは,Ga2O3中の酸素欠陥がO2導入によって減少し,実効的な正孔障壁が理論値に近づいたためと推察される。
6図でO2分圧をさらに1.0×10-1Paまで高めると,逆に暗電流は増加した。O2分圧が一定以上になると暗電流が増加に転じる理由としては,スパッター成膜中にCIGSがダメージを受けるためと考えられる。スパッター法は,アルゴン(Ar)などの導入ガスをイオン化してターゲット材料(ここではGa2O3)に衝突させ,これによりはじき飛ばされた材料が基板上に成膜される方法であるが,イオン化したArはプラスに帯電しており,マイナスに帯電させたターゲット材料に引き寄せられて衝突する。一方,O2はイオン化するとマイナスに帯電するため,マイナスに帯電したターゲット材料からは反発され,ターゲット材料の対向側にある成膜面に衝突してダメージを与える。つまり,O2分圧が増すほど,成膜面に衝突するイオンが増加し,成膜面のダメージが大きくなる。この場合,Ga2O3が成膜される下地となるCIGSの表面が欠損するため,Ga2O3とCIGSで形成されるpn接合界面に欠陥準位が多数生じる。O2分圧が小さいときは,酸素欠陥の減少による実効的な正孔障壁の増大がもたらす暗電流の低減効果が上回るが,O2分圧が一定以上になると,O2イオンがCIGSに与えるダメージの影響の方が大きくなることが,本実験で明らかになった。
O2分圧を,暗電流が最も低くなる6.0×10-2Paに設定した場合は,印加電圧3Vまで10-9A/cm2台を保持した。
Ga2O3/CIGS構造の光電流-電圧特性(入射光:波長550nm,強度50µW/cm2)を7図に示す。Ga2O3成膜時のO2分圧は,暗電流の観点から最適化した6.0×10-2Paである。光電流は,印加電圧0~1.5Vくらいまでは低く推移する。これはpn接合において光電変換が行われる領域となる空乏層*17 が,Ga2O3側に支配的に広がっているためである。一般に,pn接合での空乏層の広がり方は,p型半導体とn型半導体のキャリア濃度*18 の差や印加電圧などによって決まるが8),CIGSのキャリア濃度(1015~1017cm-3)はGa2O3のキャリア濃度(~1010cm-3)と比較して5桁以上大きいため,印加電圧が低いと空乏層はGa2O3側のみに広がる。印加電圧が2Vを超えると信号電流が増加を始めるが,これは電圧を印加したことによって空乏層がCIGS側にも広がり,入射光がCIGS内で光電変換され始めたことを示している。印加電圧をさらに高めると,4V付近で信号電流は飽和状態になった。入射した光子はCIGS内に広がった空乏層で電子・正孔対(信号電荷)に変換されるが,その一部は膜内やpn界面に存在する準位などを介して再結合され,残りが電極から取り出されて信号電流となる。電界が強くなるにつれて電子や正孔を電極側へ引っ張る力が強くなるため,電子や正孔が再結合される割合は減少し,信号電荷として取り出せる割合が増える。4V付近で見られた信号電流の飽和は,再結合される割合と信号電流として取り出される割合が平衡状態に達したことを表している。さらに印加電圧を高めると,4.5Vを超えた付近で信号電流の急激な増加が見られた。
8図にGa2O3/CIGS構造の分光感度特性を示す(入射光子数:1×1014個/cm2・s)。印加電圧1Vまでは,波長400nm以下の短波長側に感度が偏っている。これは上述したように,印加電圧が低いときには空乏層がGa2O3側に支配的に広がっており,Ga2O3のバンドギャップに対応した紫外線領域の感度しか得られないためである。印加電圧を2Vまで上げると可視光に対する量子効率が数%まで上昇し,空乏層がCIGS側に広がり始めたことが確認できる。光電流-電圧特性における信号電流の飽和領域である印加電圧4Vにおいて,量子効率は95%(波長400~700nmの平均値)となった。信号電流が増加を始める印加電圧4.5Vでの量子効率は100%を超えた。量子効率が100%を超えるということは,1個の入射光子に対して1個以上の電子・正孔対が生成されることを意味しており,光電変換膜内で何らかの電荷増倍現象が起きていることを示唆している。さらに印加電圧5Vでの量子効率は約200%に達した。




6.おわりに
カルコパイライト系材料であるCIGSに,正孔注入阻止層としてGa2O3を適用したGa2O3/CIGS構造を提案し,本構造において,暗電流10-9A/cm2台(印加電圧3V時),および一次量子効率(電荷増倍前の量子効率)95%(印加電圧4V時)を実現した。また,CMOS回路の耐電圧以下である印加電圧5Vで量子効率約200%を得ることができた。
今後の課題としては,CIGSの成膜プロセス温度をCMOS回路の耐熱温度である350~400℃まで低減することや,シリコンフォトダイオードと同程度(10-10A/cm2以下)まで暗電流を低減すること,増倍率のさらなる向上などが挙げられるが,これらの課題を解決し,早期に撮像特性の評価に取り組みたい。
謝辞 本稿に関し,半導体物性について有益な議論と貴重なご助言をいただいた慶應義塾大学理工学部 太田英二教授に深く感謝いたします。また,CIGSの物性や成膜法について有益な議論と貴重なご助言をいただいた東京理科大学 中田時夫教授に深く感謝いたします。
本稿は,Sensors and Actuators A:Physical誌に掲載された以下の論文を元に加筆・修正したものである。
K. Kikuchi, S. Imura, K. Miyakawa, H. Ohtake, M. Kubota and E. Ohta:“Photocurrent Multiplication in Ga2O3/CuInGaSe2 Heterojunction Photosensors,” Sensors and Actuators A:Physical,Vol.224,pp.24-29(2015)